Flip Chip Adhesive Bond Technologies
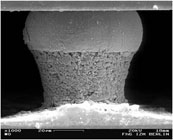

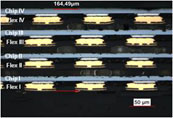
Aufgrund großer Fortschritte in der Material- und Prozessentwicklung im Bereich der Klebetechnik, nimmt diese inzwischen einen wachsenden Anteil an den Verbindungstechnologien, z.B. neben den Lötverfahren ein. Die Ausbreitung von Anwendungsfeldern für die Klebetechnologie ist die Folge. Diese reichen von sog. Low-Cost-Produkten in der Verbrauchselektronik bis hin zu Hochtechnologieanwendungen z.B. in der Medizintechnik. Der Schwerpunkt liegt auf der Anwendung und Entwicklung von Flip Chip Klebetechnologien basierend auf den Verfahren:
- Anisotrop leitfähiges Kleben (anisotropic conductive adhesive, ACA)
- Nicht leitendes Kleben (non conductive adhesive, NCA)
- Isotrop leitfähiges Kleben (isotropic conductive adhesive, ICA)
Als technologischer Vorteil aller drei Klebeverfahren ist die geringere Prozesstemperatur z.B. im Vergleich zum herkömmlichen Löten hervorzuheben. Außerdem bieten die Klebeverfahren auch Möglichkeiten zum Kontaktieren auf nicht lötfähigen Oberflächen sowie sehr gute Ergebnisse auf dem Gebiet der Fine Pitch Anwendungen. Unter Einbeziehung der gesamten Prozesskette, angefangen bei der Materialauswahl, dessen Charakterisierung und evtl. Modifikation, Einhaltung der Bondparameter bis hin zu geeigneten Testverfahren zur Qualifikation, können optimale Ergebnisse erzielt werden.
Beim anisotrop leitfähigen Kleben (ACA) wird die elektrische Verbindung zwischen Chip und Substrat durch leitfähige Partikel (Metall, metallummanteltes Polymer) im Klebstoff erzielt. Diese sind in der Klebstoffmatrix wahllos verteilt, und werden während des Bondprozesses zwischen den Elektroden eingeklemmt. Vorteile der ACA Klebstoffmaterialien liegen in der relativ einfachen Applikationsmöglichkeit von ACA Paste oder ACA Filmen, seiner schnellen Aushärtung bei relativ geringen Temperaturen und einer sehr hohen Fine Pitch Kompatibilität (≤ 40µm). Dies eröffnet Anwendungsgebiete wie z.B. Chip-on-Flex (COF) für kontaktlose Chipkarten, RFID-Applikationen und die Treiberchipmontage für Displays.
Die Technologie des nicht leitfähigen Klebens (NCA) wird oft im Zusammenhang mit sog. Au-Stud Bumps oder anderen, vorzugsweise weichen Chip- oder Substratmetallisierungen verwendet. Aufgrund hoher Prozessflexibilität eignet sich das Verfahren insbesondere für die Montage von Prototypen (Single-Chips) und MEMS-Applikationen. Es werden sehr geringe und langzeitstabile Kontaktwiderstände erzielt, welche mit denen aus Lötverbindungen oder dem Thermokompressionsbonden vergleichbar sind.
Beide bisher beschriebenen Technologien sind sogenannte Thermodenbondprozesse, welche während des Verbindungsprozesses die Aufbringung einer Bondtemperatur und Bondkraft erfordern. Ergänzend kann das isotrop leitfähige Kleben (ICA) als eine zum konventionellen Flip Chip Löten kompatible Technologie betrachtet werden. Hierbei können prinzipiell gleiche Technologien und Geräte, wie Drucker, Pick&Place-Automaten, Reflow-Öfen und Dispenser für die Klebstoffapplikation, Bauteilplatzierung, Klebstoffaushärtung und Underfill-Applikation verwendet werden. Es existiert eine große Auswahl an Klebstoffen und Underfill-Materialien, um den Material- und Produktanforderungen gerecht zu werden. Mittels ICA werden typischerweise temperatur- und / oder druckempfindliche Bauteile wie Drucksensoren, Bauelemente für die Medizintechnik oder Pixel Detektoren aufgebaut.
Veröffentlichungen
Haberland, J., Becker, M., Lütke-Notarp, D., Kallmayer, Ch., Aschenbrenner, R., Reichl, H., „Ultrathin 3D ACA Flip Chip-in-Flex Technology“, International Conference and Exhibition on Device Packaging 2010, March, 8 – 11, Scottsdale/Fountain Hills, AR, USA
Haberland, J., Kallmayer, Ch., "Ultra Thin Flip Chip Interconnects", Frequenz - Zeitschrift für Telekommunikation, 3-4/2004, Band 58, Seiten 65-69
Haberland, J., Kallmayer, Ch., Aschenbrenner, R., Reichl, H.,"Current Loadability of ICA for Flip Chip Applications", 4th IEEE Electronics Packaging Technology Conference - EPTC 2002 Singapore, December 10-12, 2002
Haberland, J., Kallmayer, Ch., Aschenbrenner, R., Reichl, H., "Fundamental Studies of Isotropic Conductive Adhesive Focused on the Current Loadability of ICA for Flip Chip Applications", 1st Int. IEEE Conference on Polymers and Adhesives in Microelectronics and Photonics - Polytronic 2001 Potsdam, Germany, October 21-24, 2001
 Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM
Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM