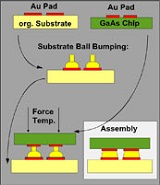
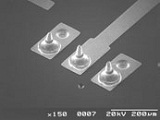
Das Gold-Stud-Bumping chip- oder substratseitig ist für das Flip-Chip-Bonding von III/IV-Halbleitern (GaAs, InP) wie FET, HEMT, MMIC oder optoelektronischen Anwendungen besonders geeignet. Das Gold-Stud-Bumping kann mit gängigen Ball-Wedge Bondern durchgeführt werden und stellt ein äußerst flexibles Verfahren für die Prototypenfertigung aber auch für kleine oder mittlere Serien dar. Der minimal erreichbare Pitch ist abhängig vom genutzten Draht. Mit gängigen Durchmessern ist eine Pitch von 60 µm bei einer Bumphöhe von 45 µm einstellbar. Für höhere Bumps steht das „stacked bumping“, das Übereinandersetzen von Bumps, zur Verfügung. Die galvanische Abscheidung von Goldkontakten eignet sich hingegen für die Prozessierung von Wafern.
Ein geeigneter, flussmittelfreier Kontaktierungsprozess für die Verbindung von Gold zu Gold ist im Thermokompressionsbonding gegeben. Hierbei wird durch das Einbringen von Kraft und Temperatur eine Verbindung zwischen dem Gold Bump und der Gold-Pad-Metallisierung erzeugt. Besonders eignet sich das TC-Bonding für RF-Komponenten (Mixer, Multiplexer, SAW) aber auch für optoelektronische Bauteile. Mögliche Materialien sind chipseitig Si, GaAs und InP und substratseitig Keramik, Glas, Si, Laminate, PI-Flex und Leadframes.
 Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM
Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM