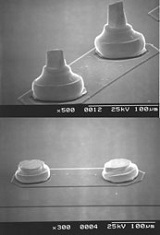
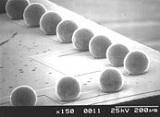
Bei der Flip-Chip-Montage wird ein Bare Die (Nacktchip) über kleine Kontakthöcker, so genannte Bumps, direkt mit dem Substrat verbunden. In der Serienfertigung werden diese Bumps in der Regel galvanisch auf dem Wafer erzeugt, gegebenenfalls gefolgt von einem Umschmelzen der abgeschiedenen Lotzylinder zu kugelförmigen Bumps. Müssen einzelne Chips oder einzelne Wafer mit Bumps versehen werden, sind mechanische Verfahren zur Herstellung der Bumps infolge geringerer Einrichtungskosten besser geeignet. Man spricht in diesem Fall von Stud Bumping.
Die mechanische Herstellung der Stud Bumps basiert auf einem Drahtbondprozess, bei dem der Draht mit einem softwaremodifizierten Drahtbonder im Ball-Wedge-Verfahren aufgebracht wird. Nach der Erzeugung des Balls wird jedoch kein Wedge erzeugt, sondern der Draht direkt über dem Ball abgerissen. Teilweise werden die Bumps noch mit einem speziellen Werkzeug abgeflacht und auf eine gleichmäßige Höhe gebracht (Coining). In speziellen Bump-Bondern ist der Vorgang des Nivellierens im gleichen Arbeitsschritt wie das Aufbringen des Bumps möglich. Hierbei schert die Kapillare des Bondwerkzeugs den Bump auf einer definierten Höhe ab. Als Endmetallisierung können alle drahtbondfähigen Oberflächen bearbeitet werden. Je nach verwendetem Drahtmaterial werden folgende Stud-Bump-Verfahren unterschieden:
Gold Stud Bumping
Beim Gold Stud Bumping wird Draht aus reinem Gold beziehungsweise aus einer Goldlegierung verwendet. Einsatz finden Gold Stud Bumps bei der Flip-Chip-Montage durch Thermokompressionsbonden oder Thermosonicbonden. Zuverlässige Kontakte, die mittels Thermokompressionsbonden hergestellt werden, benötigen Temperaturen ab
250 °C. Beim Thermosonicbonden ist ein Absenken der Bondtemperaturen auf 150 °C möglich. Gold Stud Bumps sind auch zum Kleben mit ICA (Isotropic Conductive Adhesive) und NCA (Non Conductive Adhesive) geeignet. Vorteil dieses Verfahrens ist die geringe Temperaturbelastung.
Bei Verwendung von reinem Gold reißt der Draht beim Stud-Bump-Prozess nicht definiert ab und muss abgeflacht und auf eine gleichmäßige Höhe gebracht werden (Coining). Mit Goldlegierungen können geringe und gleichmäßige Abrisslängen erreicht und auf ein nachträgliches Coining verzichtet werden.
Platin als belotungsfähiger Bump
Sollen Flip Chips in einem Reflowprozess montiert werden, muss zunächst eine benetzbare Oberfläche auf der Aluminiumendmetallisierung des ICs geschaffen werden. Diese besteht in der Regel aus Gold, Palladium oder Platin, wobei sich Platin als am besten geeignet herausgestellt hat. Untersuchungen von Platin als belotungsfähiger Bump zeigen bei Zuverlässigkeits-Tests (Langzeit-Temperatur-Cycling) und anschließender Untersuchung mittels Rasterelektronenmikroskopie die besten Ergebnisse. Im Vergleich zum Gold entstehen bei Verwendung von Platin in der Lötstelle keine spröden und brüchigen intermetallischen Phasen. Auch Palladium weist eine schlechte Langzeitzuverlässigkeit auf. Die Ausbildung intermetallischer Pd-Sn-Phasen führt zu Haftverlusten zwischen Palladium und dem Basismaterial.
Bei der Herstellung der Stud Bumps werden diese nach dem Drahtbondprozess abgeflacht, um eine glatte Oberfläche für den nachfolgenden Belotungsschritt zu erhalten.
Substratseitig können Lotkugeln oder Lot Stud Bumps genutzt werden. Beim Aufschmelzen des Lotes wird dann die Platin Stud Bumps benetzt.
Kupfer als belotungsfähiger Bump
Erste Untersuchungen liegen auch für Kupfer als belotungsfähigem Bump vor. Bei dieser Methode ist die genaue Auswahl der Bumpingparameter jedoch von entscheidender Bedeutung, und im Vergleich zum Platin ist die erreichbare Zuverlässigkeit wegen der hohen Härte des Kupfers geringer. Der Vorteil von Kupfer liegt in seinen geringen Materialkosten und der langsameren Ausbildung einer intermetallischen Cu-Al-Phase. Jedoch ist beim Aufbringen der Kupfer-Stud-Bumps eine spezielle Atmosphäre nötig, um die Oxidation des Kupfers zu verhindern.
Bumpdurchmesser, Pitch und Höhe können applikationsspezifisch eingestellt werden. Derzeit werden standardmäßig Bumps mit einem Durchmesser von 30 bis 80 µm erzeugt. Hierfür verwendet man Drähte, die einen Durchmesser zwischen 18 und 25 µm besitzen. Möchte man höhere Bumpdurchmesser erreichen, ist der Einsatz eines Drahtes mit 33 µm Durchmesser sinnvoll. Zurzeit lässt sich ein minimaler Pitch bis 50 µm erreichen, eine weitere Reduzierung bis auf 40 µm ist bei optimalen Bedingungen möglich. Die Bumphöhe lässt sich ab 20 µm aufwärts einstellen; werden hohe Bumps benötigt, kann ein Stacking von zwei oder drei Stud Bumps durchgeführt werden.
Bei der Qualifizierung geeigneter Drahtmaterialien und Methoden zum Single Chip Bumping stehen umfangreiche Untersuchungsmöglichkeiten zur Verfügung, dazu gehören Lichtmikroskopie, REM, IR-Mikroskopie, FIB-Präparation sowie Pulltests, Schertests und Prüfungen nach standardisierten Testverfahren (z. B. MIL Standard 883).
Bei einem Setup werden zunächst Bumpdurchmesser, Pitch und Höhe vereinbart und anschließend die dafür erforderlichen Prozessparameter ermittelt. Anschließend werden die vereinbarten Spezifikationen getestet und Musteraufbauten oder Kleinserien hergestellt. Dabei bietet das Fraunhofer IZM Unterstützung bei der Herstellung von:
- Ultra Fine Pitch
- Stacked Bumps
- Coined Bumps
Hierbei kann mit verschiedenen Materialien wie Gold, Kupfer, Silber, Palladium oder Platin gearbeitet werden. Neben der Möglichkeit der Verarbeitung einzelner Chips können am Fraunhofer IZM auch komplette Wafer von 4“ bis 300 mm mit Stud Bumps versehen werden
Im Rahmen eines Technologietransfers bieten wir auf Wunsch auch Schulungen an.
Dem Institut stehen automatische Ball Bumper vom Einzelchip bis zu 300 mm Wafergröße zur Verfügung.
 Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM
Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM