Drahtbonden
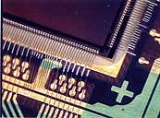

Das Drahtbonden (engl. Wire Bonding) stellt ein Standardverfahren zur elektrischen Kontaktierung in der Aufbau- und Verbindungstechnik dar, das in der Halbleitermontage vielfach eingesetzt wird. Anwendungen liegen beispielsweise in der Chip-onBoard-Technik, Leistungsmodul-Technologie, Hochfrequenztechnik oder in der Montage von Mikrosystemen. Bei diesem Verfahren wird die elektrische Verbindung in der Regel über Drähte aus Aluminium, Gold, Kupfer oder Silber hergestellt, die mit unterschiedlichen Techniken durch die zeitlich begrenzte Einwirkung von Druck, Temperatur und/oder Ultraschall im festen Zustand miteinander verbunden werden. Dabei nehmen die Kontaktstellen die Form eines Keiles (Wedge) oder einer Kugel (Ball) an. Als Standardverfahren wendet man bei Aluminium- oder aluminiumbeschichteten Drähten das Ultraschall (US)-Wedge/Wedge-Bonden an, bei Gold- oder Kupferdrähten kommt in der Regel das Thermosonic (TS)-Ball/Wedge-Verfahren zum Einsatz.
Im Fokus der Aktivitäten des Fraunhofer IZM stehen Entwicklung und Erprobung neuer Drahtmaterialien und Oberflächen, die Verbesserung des Verständnisses für den Verbindungsbildungsprozess sowie die Weiterentwicklung von Prüfverfahren. Die derzeitigen Entwicklungen im Bereich des Drahtbondens, bei denen das Institut seine Partner gerne begleitet, zeigen folgende Trends:
- Automatische Verarbeitung immer dünnerer Drähte bei zunehmend verringerten Pitches: Fine Wire Bonding < 20 µm, Ultra Fine Pitch < 50 µm
- Neue Drahtmaterialien: Erprobung alternativer Legierungen, ummantelte Drähte, etwa Al/Cu-Bimetalldrähte
- Erweiterung der marktverfügbaren Finish-Metallisierungen insbesondere für multifunktionale Anwendungen: Chemisch-Ag, Ni/Pd/Au, Cu/Pd, oder Cu mit Schutzschichten
- Hochtemperaturelektronik: Einsatz von Bondmaterialien für einen Temperaturbereich bis 250 °C
- Bonden von komplexen bzw. anspruchsvollen Systemen: HF-Module oder Mikrosysteme/MEMS-Devices
- Optimierung gängiger Prüfverfahren für Qualität und Zuverlässigkeit von Bondverbindungen: Schertest, Pulltest, Ätzverfahren
- Verständnis der Wechselwirkung zwischen Oberflächenzustand und Bondqualität: Entwicklung geeigneter Methoden zur prozessnahen Oberflächenanalytik
Zu den umfangreichen Arbeiten des Instituts gehören
- die Prüfung von Oberflächen mit unterschiedlichen Verfahren (Lichtmikroskopie, REM, Kontaminationsprüfungen mittels ESCA, FIB-Präparation und Schichtdickenmessung mittels RFA),
- schnelle und aussagefähige Bondtests (Pulltests, Schertests, Interfaceanalysen durch Abätzen von Ballbondverbindungen) sowie
- Prüfungen nach standardisierten Testverfahren zur Qualitäts- und Zuverlässigkeitskontrolle (z. B. MIL Standard 883) und kundenspezifischen Normen.
Weiterhin bietet das Fraunhofer IZM Unterstützung bei:
- Bondbemusterungen (Qualifizierung von Oberflächen bezüglich der Bondbarkeit)
- Aufbau auch komplexer Prototypen (Leiterplatte/COB, Keramik, Gehäuse, Leadframe)
- Kleinstserienfertigung
- Machbarkeitsstudien
- Prozessentwicklung
- Technologische Beratung
- Schulungen
In regelmäßigen Abständen bietet das Institut Schulungen zum Die- und Drahtbonden mit intensivem Theorie- und Praxisteil für Manager, Entwickler und Konstrukteure an. Eine umfangreiche Ausstattung mit Drahtbondgeräten unterschiedlicher Hersteller ermöglicht es unseren Wissenschaftlern, gezielt ein breites Knowhow an Partner aus Industrie und Wissenschaft weiterzugeben. Zum Equipment gehören unter anderem:
 Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM
Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM