Flip Chip Löten auf flexiblen Substraten
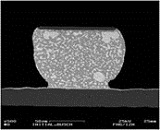

Das Flip Chip Löten auf flexiblen Substraten stellt unter Verwendung von standardmäßigem Pick und Place Equipment heutzutage eine zuverlässige Technologie dar, um Chips bis zu einem Pitch von ca. 150µm zu kontaktieren. Besonderes Augenmerk muss auf die Wahl geeigneter Metallisierungen für die Kontakte gelenkt werden, sowie auf die Anforderungen hinsichtlich des Handlings und eines eventuell notwendigen Aufspannens der flexiblen Substrate, um eine ausreichende Planarität während des Lötprozesses zu gewährleisten. Um optimale Zuverlässigkeitsergebnisse zu erzielen, ist ein Unterfüllen der Kontakte und Chipflächen erforderlich. Dies geschieht entweder in einem dem Lötprozess nachgeschalteten Underfilling mittels Dipenser oder Jetter oder durch Verwendung von Noflow-Underfillern, welche vor dem eigentlichen Lötprozess aufgebracht werden und dann während des Reflowlötens aushärten.
Verschiedenstes Equipment zur hochpräzisen Platzierung von Flip Chips und diskreten Bauteilen ist in unserer Bestückungslinie vorhanden (Datacon evo, Siemens Siplace X-Placer). Die Lötprozesse können auch in inerter Atmosphäre durchgeführt werden.
Je nach Temperaturempfindlichkeit der Chips als auch der Substratmaterialien können unterschiedliche Lote auf die Kontaktpads der Flip Chips aufgebracht werden (SnCu, SnAgCu, AuSn, SnBi, PbSn). Alternativ ist auch der Schablonendruck von Lotpaste auf die substratseitigen Pads möglich.
Zuverlässigkeitsuntersuchungen an Flip Chip auf Flex-Modulen, welche im dargestellten Verfahren montiert wurden, zeigten keinerlei Ausfälle bis zu 10.000 thermischen Zyklen (-55°C/25°C/+125°C). Die Flip Chip auf Flex Technologie ist eine zuverlässige Verbindungstechnologie zur weiteren Miniaturisierung von Produkten z.B. im medizintechnischen Sektor.
Veröffentlichungen:
[1] B.Pahl et al., “Long time reliability of flip chip interconnections on Flexible substrates”, Proceedings of IMAPS conference 2002, Denver USA
[2] B.Pahl et al., “Flex Technology for Foldable Medical Flip Chip Devices”, Proceedings of Device Packaging conference 2008, Scottsdale USA
 Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM
Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM