Montage ultradünner Flip Chips – Löten und Kleben

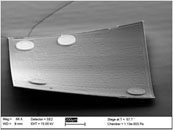
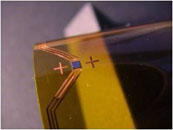
Ein neuer Ansatz zur Miniaturisierung elektronischer Module liegt in der Integration ultradünner IC’s und in der dreidimensionalen (3D) Anordnung extrem dünner Module. Wafer werden heute auf bis zu 50µm oder sogar weniger abgedünnt. Dies eröffnet z.B. den zahlreichen RFID-Applikationen neue Möglichkeiten. Flexible Antennensubstrate mit montierten RFID Chips sind nicht mehr stärker als insgesamt 50µm und ermöglichen somit die vollständige Integration in z.B. Polycarbonat für Zugangs- oder Identifikationskarten oder sogar in Papier.
Neben den extrem abgedünnten Chips ist eine geringe Bumphöhe Voraussetzung für sehr flache Module. Galvanisch abgeschiedene Metallisierungen mit z.B. CuSn oder AuSn als Lotzusammensetzung eignen sich für sehr kleine und flache Bumps. Die Flip Chips werden im Thermodenbondverfahren unter Verwendung von Flip Chip Bondern gelötet. Stromlos abgeschiedene NiAu Bumps sind eine kostengünstige Alternative für Flip Chip Module, die im Klebeverfahren hergestellt werden. Ein Vorteil der Flip Chip Klebetechnologie liegt in geringen notwendigen Prozesstemperaturen gegenüber dem Löten. Daraus resultieren eine geringe Temperaturbelastung des Substrates und folglich weniger mechanische Spannungen im fertigen Modul bei Raumtemperatur.
Sowohl für das Thermodenlöten als auch für die in Klebetechnologie aufgebrachten Flip Chips sind hochpräzise Flip Chip Bonder notwendig und vorhanden. Beide Technologien bedingen Erfahrungen und tiefes Verständnis für Herausforderungen hinsichtlich der erforderlichen Werkzeuggeometrie, eventueller Antihaftbeschichtungen und v.a. zur Einstellung und Auswahl geeigneter Bondparameter. Die Montage ultradünner Flip Chips ist außerdem sehr sensitiv bezüglich der aufzubringenden Kräfte, um ein Brechen der Chips zu vermeiden und trotzdem eine zuverlässige Kontaktierung zu gewährleisten. Zuverlässigkeits-untersuchungen an ultradünnen Flip Chip Aufbauten auf flexiblen Substraten zeigen sowohl bei gelöteten Kontakten (CuSn) als auch bei geklebten Flip Chip Verbindungen (ACA) sehr gute und stabile Ergebnisse während der thermischen Wechselbelastung.
 Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM
Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM