Ultradünne Flip Chip Lötkontakte
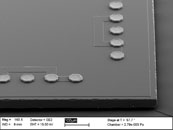
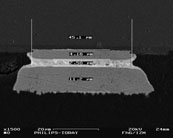
Der Trend in der Technologieentwicklung der IC’s bewegt sich in Richtung immer kleiner und komplexer werdender Chips bei einem gleichzeitigen Anstieg der Anzahl der Kontakte. Demzufolge werden die Abstände der einzelnen Kontaktpads immer geringer sowie auch die Kontaktflächen immer kleiner. Zur Vermeidung von Kurzschlüssen benachbarter Kontakte während des Lötprozesses können hier keine herkömmlichen sphärischen Lotbumps mehr verwendet werden. Dünne, galvanisch abgeschiedene Lotschichten oder flache gedruckte Lotdepots helfen Kurzschlüsse zu vermeiden. Da die Anforderungen an die Planarität hierbei stetig steigen, ist ein freier Reflowprozess meist nicht mehr möglich. Durch die Verwendung von Flip Chip Bondern können die hohen Anforderungen an die Planarität während des Lötprozesses erfüllt werden. Hierbei wird während des Kontaktierungsprozesses sowohl die erforderliche Löttemperatur als auch eine geringen Kraft auf die Flip Chips aufgebracht, um eine vollständige Kontaktierung zu gewährleisten. Zur Erhöhung der Zuverlässigkeit müssen die Flip Chips unterfüllt werden. Neue Materialien eignen sich für das nachträgliche Underfilling der sehr schmalen Spalte. Alternativ können auch meist ungefüllte Materialien, sogenannte Noflow-Underfiller verwendet werden, welche vor dem eigentlichen Kontaktierungsprozess auf die Substratseite aufgebracht werden, z.B. durch Dispensen oder Schablonen-/Siebdruck. Die hohe Zuverlässigkeit dieser dünnen Flip Chip - Lötkontakte auf flexiblen Substraten wurde bis zu einem Kontaktmittenabstand der Anschlüsse von 40µm erfolgreich nachgewiesen. Der oben beschriebene Prozess des Thermodenlötens mittels Flip Chip Bonder stellt eine hochpäzise und zuverlässige Technologie zur Kontaktierung von Flip Chips mit engen Kontaktabständen auf flexible Substrate dar. Aufgrund der geringen Lotmenge ist substratseitig keine Lötstoppmaske erforderlich, wodurch die Substratkosten reduziert werden können.
Am IZM können verschiedene Metallisierungen für dünne Lotschichten galvanisch aufgebracht werden, z.B. CuSn und AuSn. Besondere Aufmerksamkeit verdient bei den ultradünnen Kontakten die Kontaktmetallurgie, da ein Großteil des Kontaktes nach dem Löten aus intermetallischer Phase besteht. Die Prozessführung des Thermodenlötens und unsere langjährigen Erfahrungen hinsichtlich des Verhaltens der flexiblen Substrate und deren Handling gewährleisten optimale Ergebnisse und eine hohe Zuverlässigkeit der Produkte.
 Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM
Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM