Ultrafine Pitch Flip Chip Montage auf flexiblen Substraten
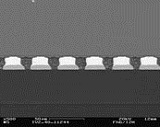
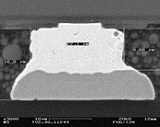

Steigende Anschlussdichten und immer kleiner werdende Kontaktflächen stellen heutzutage hohe Anforderungen an die Aufbau- und Verbindungstechnik von Flip Chips. Unter Verwendung von hochpräzisen Flip Chip Bondautomaten werden IC’s mit Kontaktmittenabständen von 40µm auf flexible Substrate gebondet. Die einlagigen sehr dünnen Polyimidsubstrate werden hierbei mittels Vakuum fixiert. Andere geometrische Möglichkeiten, z.B. das Bonden in Kavitäten, ergeben sich durch den Einsatz spezieller angepasster Substrathalterungen. Verbindungsmetallurgien, wie z.B. AuSn, mit einem nur sehr kleinen Volumen an eutektischem Lot verhindern Kurzschlüsse zwischen den eng benachbarten Bumps und gewährleisten zudem ein flussmittelfreies Löten. Der galvanische Abscheideprozess der Metallisierung für die AuSn Bumps geschieht auf Waferebene. Eine Alternative bietet das Au-Studbumping, welches ein sequenzieller Prozess ist und somit auch auf schon vereinzelten Chips und/oder auf dem Substrat erfolgen kann. Im Fall von Au-Studbumps können diese auf eine angepasste Substratmetallisierung mit einer abschließenden Sn-Schicht gelötet werden.
Das Unterfüllen der schmalen Spalte zwischen Chipunterseite und Substrat erhöht die Zuverlässigkeit der Module signifikant. Underfiller-Materialien mit angepassten sehr kleinen Partikeln erfüllen die Fließeigenschaften für solch kleine Spalte. Alternativ können Noflow-Underfiller verwendet werden, die vor dem Kontaktierungsprozess auf die zu bondende Fläche aufgetragen werden und während des Thermodenlötens aushärten.
Neben dem Thermodenlöten stellen die Flip Chip Klebetechnologien mittels gefüllter anisotrop leitender Klebstoffe eine heute gängige Verbindungstechnik dar, um Flip Chips mit sehr kleinen und dichten Kontakten aufzubauen. Treiber IC’s mit 50µm Pitch für eInk-Displays wurden auf Dünnfilmsubstrate geklebt. Hierbei wurde eine ansiotrop leitende Klebefolie verwendet.
Wir verstehen uns als Ihr Ansprechpartner für Herausforderungen beim Aufbau von IC’s mit sehr kleinem Anschlussraster.
Veröffentlichungen:
[1] B.Pahl et al., “ A thermode bonding process for fine pitch flip chip applications on flexible substrates”, Proceedings of IMAPS Nordic 2002, Stockholm, Sweden
 Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM
Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM