Neue Prozesstechnologien zur Einbettung von Elektronikkomponenten in großflächige organische Substrate
PEKOS
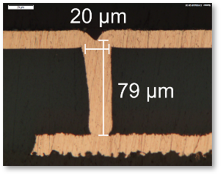
Ziel des Projekts ist die Entwicklung von Prozessen und Maschinen für den neuen Integrationsansatz in der Mikroelektronik: das Panel-Level-Packaging. Hier werden auf Basis kombinierter Leiterplatten- und Dünnschichttechnologien Mikrochips und verschiedene andere elektronische Bauteile flexibel in dünne organische Substrate eingebettet. Dies ermöglicht eine kostengünstige, großflächige Herstellung komplexer Module mit höchstem Miniaturisierungsgrad.
 Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM
Fraunhofer-Institut für Zuverlässigkeit und Mikrointegration IZM