Event / May 09, 2023 - May 11, 2023
SMTconnect
Booth: 5-447
Booth: 5-447
From May 9-11, 2023 the SMTconnect – Europe’s leading trade fair for System Integration in Micro Electronics – will be taking place in Nürnberg. Current products, services and innovations in the field of electronic manufacturing from a wide and international range will be presented to the public. Main topics are design and development, PCB production, components, assembly, soldering, packaging and test systems.
We cordially invite you to visit us at the Fraunhofer IZM booth! Here you will find the latest trends in electronic packaging, smart system integration and reliability analyses from our laboratories.
Come and see us in Hall 5/ booth 447!
Radar sensors for industrial and process metrology, as addressed in the project “Glass Interposer Technology for Implementing Highly Compact Electronic Systems for High-frequency Applications” (GlaRA) sponsored by the BMBF (Bundesministerium für Bildung und Forschung, German Federal Ministry of Education and Research), are a good example of the needs profile described above. Standard packages do not work because of the frequencies exceeding 100 GHz – higher than those of mobile communications technology – and the stricter environmental requirements. They must allow for adaptation to specialized sensor ASICs and permit manufacturing in medium-sized quantities at competitive prices.
To this end, the consortium has developed and characterized a reliable interposer technology as a system-in-package (SiP) based on glass for broadband millimeter wave modules that can be used in sensors and communication at frequencies above 100 GHz. The technology platform demonstrated here constitutes a sensor packaging revolution: Compared to the state of the art, it uses various waveguide concepts, high-density micro wiring, and hermetic encapsulation to increase functions able to be integrated. In addition, it makes applications up to 300 GHz possible thanks to high precision and material qualities. This is implemented within a single material system (glass) through excellent waveguide properties and high-precision micromachining, among others.
In the realm of system integration on boards level the IZM services range from consultation, to process development, right through to technical system solutions. Our research focusses on the development of processes and materials for interconnection technologies on board, module and package levels as well as the integration of electrical, optical and power-electronic components and systems.
More information about Substrate Integration

Robo Ray - A German research consortium including Fraunhofer IZM has developed a submarine robot that is as nimble and mobile as a manta ray and equipped with innovative connected sensors on its fins to gather more information about its surroundings. One particularly nifty trick: It can measure water pressure so precisely that metal objects can be detected on the ocean floor, even if they are covered by sediment.
Trusted data acquisition in microelectronics manufacturing as a basis for ML-optimized processing - Within the SiEvEI 4.0 project, a research consortium from industry and academia works on process digitization for a manufacturing scenario where high value electronic goods are built in a distributed manufacturing environment. The key research topics addressed are the implementation of a Chain of Trust [CoT] for trustworthy distributed manufacturing and the application of artificial intelligence/machine learning to analyze and to eventually optimize manufacturing processes.
Magnet-guided camera capsules for more pleasant gastroscopies - Abdominal pain, difficulty in swallowing, chronic coughing, vomiting, or unexplained weight loss: many symptoms can make a gastroscopic exam necessary. The everyday procedure uses a flexible endoscope to diagnose conditions affecting the upper digestive tract, but many patients are wary about having to swallow the tube and put off the often urgently required checkup. To combat this problem, the partners on the nuEndo project have come up with a special capsule that may replace the endoscopy tubes used in traditional gastroscopic procedures with a completely wireless technology. An external magnetic system is used to guide the ingested capsule through the patient’s body, from where it transmits live images captured with its built-in sensors.
The highest integration densities possible in heterogeneous assemblies are achieved using wafer-level integration. At Fraunhofer IZM all processing steps are carried out at wafer level after the actual front-end processes have been completed. The packages we develop have lateral widths almost identical to the chip dimensions. We also include active and passive components on the wafer in interlayers and even higher integration densities are achieved with 3D integration using through-silicon vias (TSV).
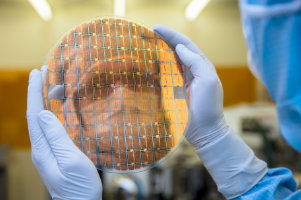
TSV into CMOS integration - The vertical arrangement of system components like logic- or memory chips as well as ASICs or sensors represents an efficient method for the volume reduction of systems but also for improvement of the systems electrical performance.
Wafer level capping - Further cost reduction, performance increase and miniaturization of electronic systems requires new highly efficient SiP concepts for MEMS components like RF resonators or switches, quartz crystals, bolometers, BAWs etc.
Fabrication of flexible high density multi-layer substrates - Fraunhofer IZM offers versatile processes for the manufacturing of high density multi-layer flex substrates. The fabrication approach features the capabilities of Fraunhofer IZMs well established wafer level redistribution technology which is applied on rigid temporary carrier wafers.
3D hybrid pixel detector module - Fraunhofer IZM in Berlin and AGH University of Science and Technology in Krakow have developed 3D hybrid pixel detector modules for X-ray imaging.
Chip-to-Wafer assembly technologies - As part of the department Wafer Level System Integration (WLSI) Chip to Wafer (C2W) assembly technologies offer a broad variety of processes to enable high density microelectronic packaging. One of the major advantages of (C2W) assembly relies on the fact that it offers principally a higher throughput compared to chip-to-chip assembly.
Full flex or rigid-flex circuits with embedded ICs or sensor devices - Fraunhofer IZM offers a variety of processes for the manufacturing of flexible or rigid / flexible high density multi-layer circuits. The fabrication approach features the capabilities of the well establisted wafer level redistribution technology, which is applied on temporary carrier wafers.
Apart from ensuring the best possible thermal system design, understanding thermomechanical behavior on package, component and module levels is critical for ensuring overall system reliability. Thermally and thermo-mechanically induced failure mechanisms can lead to premature failure and limit lifetime.

Validated warpage modelling for fan-out wafer level packaging - The production of fan-out wafer level packaging is a multi-step process. In that process, the combination of different materials creates intrinsic stresses that can cause warpage in the affected wafers. New materials testing (pTMA) procedures were integrated in the simulation workflow for technology concepts to model these warpage effects and predict how wafers change in terms of shape and size during the essential processing steps. Using these insights, designs can be assessed and optimized in terms of chip placement and the choice of materials.
Self-validation of complex electronic systems using grey box models - Using so-called grey box models it will be possible to detect signs of wear or manipulation in electronic systems at an early stage, before an actual failure occurs. A research project at Fraunhofer IZM is contributing to a future of more elegant, sustainable and energy-efficient solutions in this area. As part of the SesiM project, which began last summer under the leadership of Siemens AG, Fraunhofer researchers are working together with other partners from the fields of mobility and artificial intelligence to find self-validation solutions for complex electronic systems. Focusing on automotive and rail applications, the researchers are investigating how these systems could assess themselves and report on their condition, for example via an integrated light system.
Analytical, numerical and experiment-based assessment of electromigration in electrical contacts - One factor limiting the reliability of increasingly miniaturized electronic systems is failure due to electromigration. This current- and temperature-induced mechanism displaces atoms in the conducting material, leading to defects in the electrical traces and solder joints. Any investigation of electromigration as part of optimized, model-based evaluation has to take into account the effects of interdependent parameters.